IGBT 模塊主要有 IGBT 芯片、Diode 芯片、tacit絕緣基板)、鋁線、硅凝膠、電極、外殼組成。
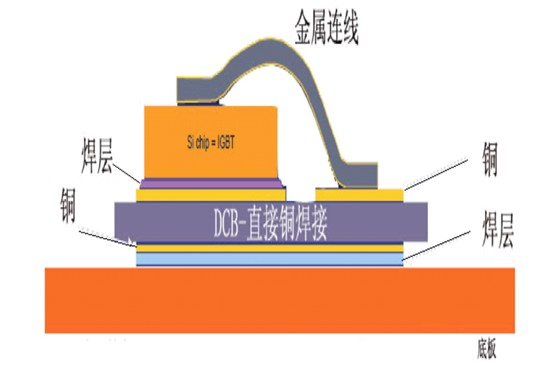
圖 IGBT模塊結構
1、IGBT和DIODE芯片——實現電氣性能;實現電氣性能;
2、絕緣基板——實現電氣絕緣,形成導熱通道,保實現電氣絕緣,形成導熱通道,保證導熱性能。
3、底板——形成導熱通道,保證導熱性能,增強模形成導熱通道,保證導熱性能,增強模 塊的機械性能。
4、外殼——形成密閉空間,保護內部組件,提供機形成密閉空間,保護內部組件,提供機 械支撐,保證絕緣能力。
5、灌封材料——實現與外界環境隔離,保證密封和實現與外界環境隔離,保證密封和絕緣,防潮濕,防振動,提供安全使用環境。
6、電極——實現內部功率器件與外部電路的連接,實現內部功率器件與外部電路的連接, 保證模塊通流能力 保證模塊通流能力。
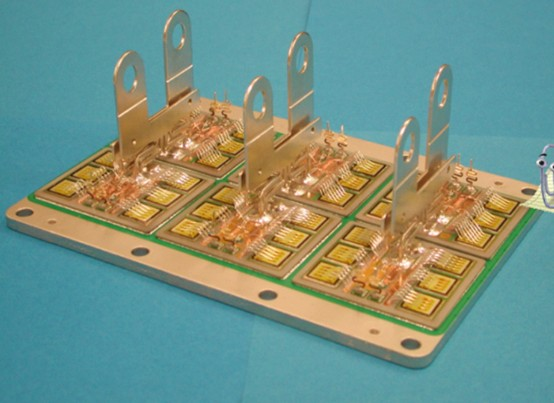
IGBT模塊的主要封裝技術
1、焊接,進行芯片與焊接,進行芯片與DBC基板、DBC基板與底板、DBC 基板與電極的焊接;形成導電、導熱通道,滿足通流和導熱要求。焊接要求焊接面沾潤好,空洞率小,焊層均勻,焊接牢固。
2、鍵合,進行芯片的鍵合連接;是用金屬絲將芯片電極與用金屬絲將芯片電極與DBC板進行連接, 形成模塊內部電連接 形成模塊內部電連接。
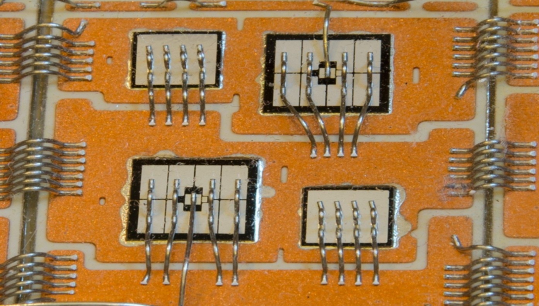
鍵合原理是通過破壞被焊表面的氧化層和污染,使鍵合原理是通過破壞被焊表面的氧化層和污染,使其產生塑性變形,使得引線與被焊接面緊密接觸,其產生塑性變形,使得引線與被焊接面緊密接觸,達到原子間的引力范圍并導致界面間原子擴散而形達到原子間的引力范圍并導致界面間原子擴散而形成焊接點。
鍵合要求鍵合線線徑合適,長度相等;鍵合點連接鍵合要求鍵合線線徑合適,長度相等;鍵合點連接牢固,分布均勻,滿足通流要求等。
3、外殼安裝,進行外殼和頂蓋的安裝;提供機械支撐,保護模塊內部組件,防止灌封材料外溢,保證絕緣能力
通過特定的工藝過程完成外殼、頂蓋與底板結外殼安裝是通過特定的工藝過程完成外殼、頂蓋與底板結構的固定連接,形成密閉空間。
外殼、頂蓋材料要求機械強度和絕緣強度高,耐高溫,不易變形,防潮濕、防腐蝕等。

圖 PPS材料IGBT外殼 來源:昆山欣達
4、灌封,進行灌封材料填充,實現與外界隔離;避免模塊內部組件直接暴露于環境中,提高組件間的絕緣,提升抗沖擊、振動能力。
采用特定的灌封工藝,用特定的灌封材料灌封是指采用特定的灌封工藝,用特定的灌封材料 填充模塊,將模塊內組件與外部環境進行隔離保護。
灌封材料要求化學特性穩定,無腐蝕,具有絕緣和散熱能力,膨脹系數和收縮率小,粘度低,流動性好。
文章來源:艾邦半導體



