先進封裝 (AP) 是指封裝集成電路 (IC) 以提高性能的多種創新技術。與傳統封裝相比,它具有高集成度、工藝方法更加多元以及更優的導電和散熱性能等優點。
先進封裝的結構大致包括:倒裝芯片(Flip-Chip,FC)、2.5D封裝與3D封裝、晶圓級封裝(Wafer Level Package,WLP)、系統級封裝(SiP)、Chiplet。
先進封裝的工藝大致含有:Bump(凸塊)工藝、RDL(重布線層)工藝、TSV(硅通孔)工藝。
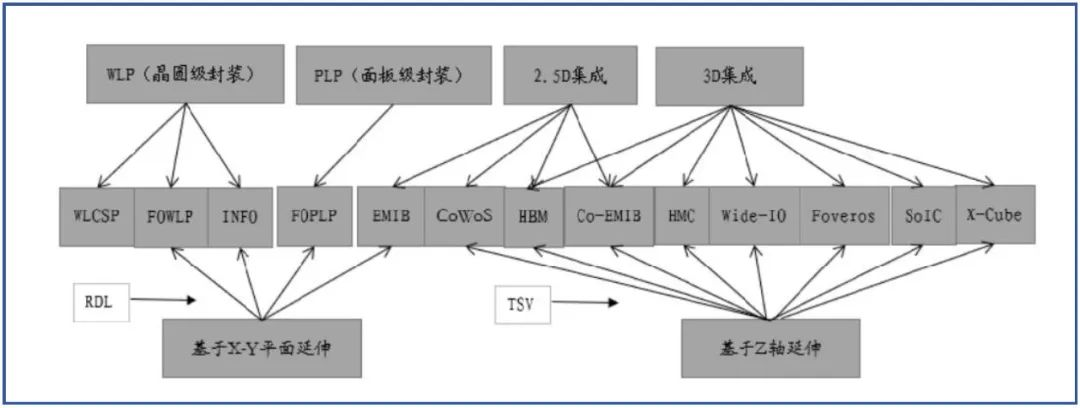
先進封裝結構
倒裝芯片(Flip chip)
在傳統封裝技術中,芯片被封裝在底部,并通過金線連接到封裝基板上。而倒裝芯片技術則將芯片直接翻轉并安裝在封裝基板上,然后使用微小的焊點或導電膠水進行連接。這種封裝技術具有較高的信號密度、較小的體積、高速傳輸和良好的熱傳導性能,因此在半導體行業得到了廣泛應用。
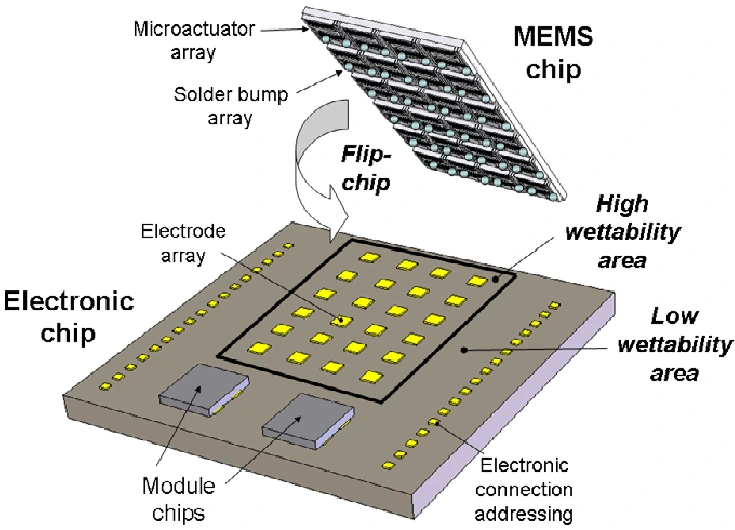
2.5D封裝與3D 封裝
2.5D 封裝:采用硅或重分布層 (RDL) 扇出的中介層被用于在 SoC 的裸片之間路由信號;3D 封裝:采用混合鍵合或以上技術的某種組合來實現芯片的垂直堆疊。
2.5D/3D 堆疊封裝涉及垂直堆疊多個裸片或芯片,形成三維結構。該平臺可實現更高的集成度、更高的性能和更小的外形尺寸,使其成為應對人工智能、5G 和 HPC 應用挑戰的重要技術。
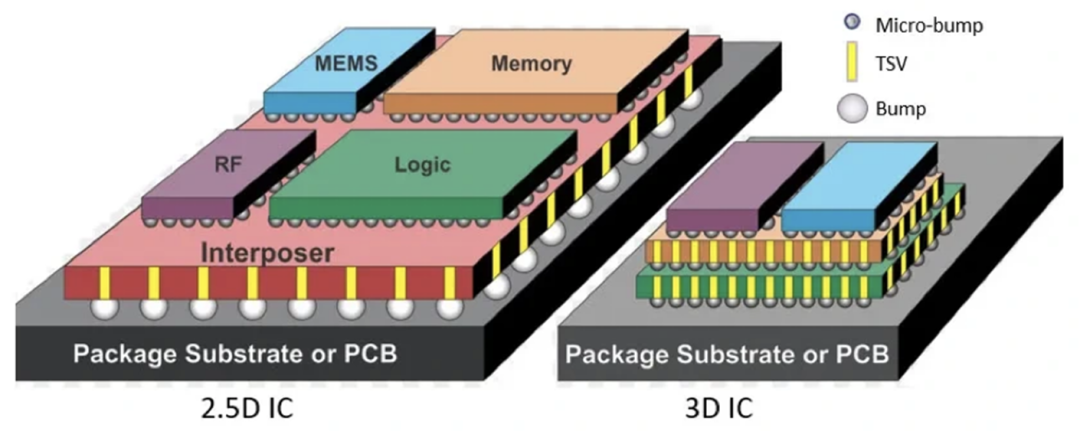
晶圓級封裝
晶圓級封裝是在切割晶圓成單個芯片之前,在整個晶圓上進行封裝過程。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
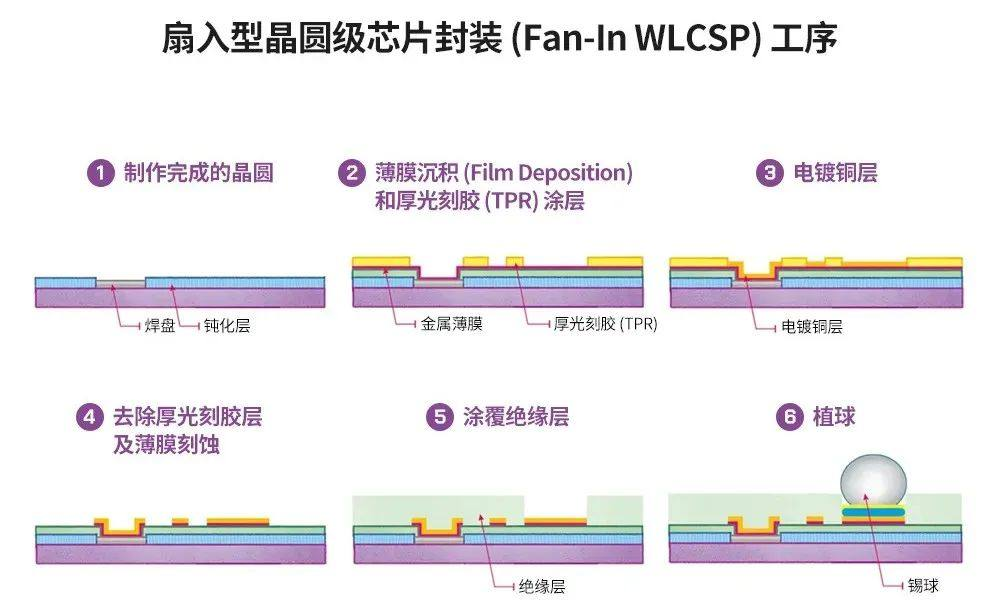
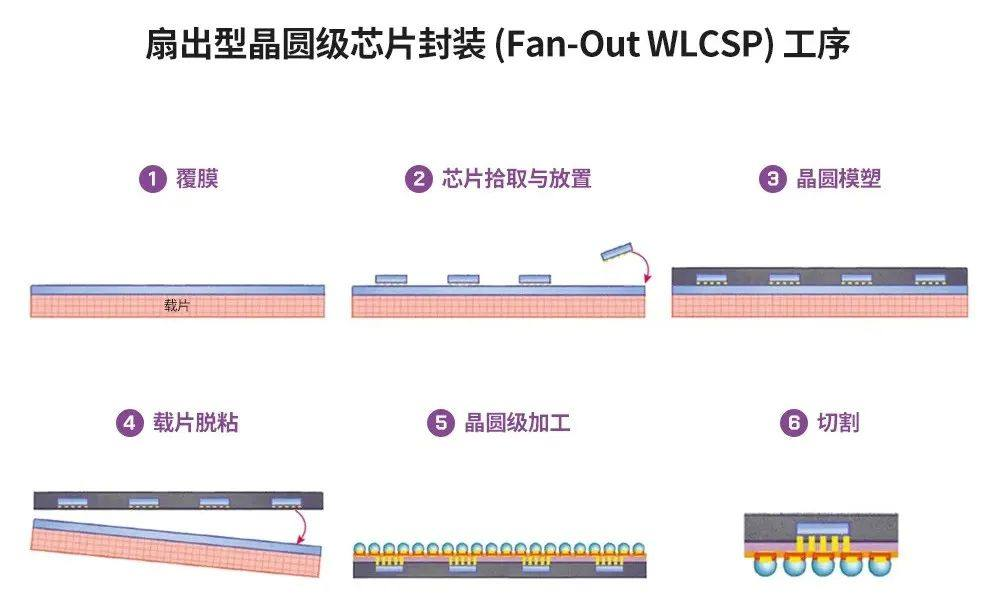
系統級封裝(SiP)
系統級封裝(SiP)技術是通過將多個裸片(Die)及無源器件整合在單個封裝體內的集成電路封裝技術。在后摩爾時代,系統級封裝(SiP)技術可以幫助芯片成品增加集成度、減小體積并降低功耗。
Chiplet
Chiplet是一種集成電路設計和封裝方法,它將一個芯片(稱為主芯片)與多個輔助芯片(稱為chiplet)集成在一起,以形成一個功能完整的系統。Chiplet技術的出現是為了解決集成電路尺寸和復雜性不斷增加所帶來的挑戰,提高系統集成度、性能和靈活性。
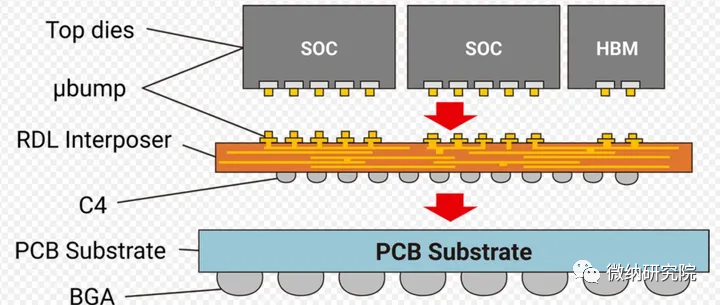
先進封裝工藝
Bump(凸塊)工藝
凸塊制造技術(Bumping)是在芯片上制作凸塊,通過在芯片表面制作金屬凸塊提供芯片電氣互連的“點”接口,廣泛應用于 FC、WLP、CSP、3D 等先進封裝。Bumping 工藝介于產業鏈前道集成電路制造和后道封裝測試之間,是先進封裝的核心技術之一。
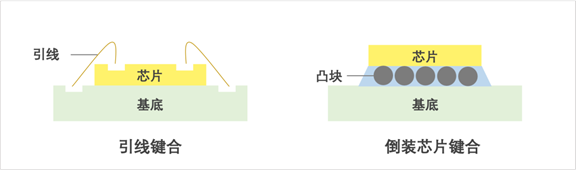
RDL(重布線層)工藝
RDL是指重新布線的行為。該工藝的目的是通過添加額外的金屬層來重新排列晶圓上已經形成的鍵合墊。RDL技術是一種晶圓級工藝,只重新配置焊盤,經過RDL的晶圓要經過傳統的封裝工藝來完成封裝。下圖顯示了使用RDL技術將襯墊重新分配到邊緣的中心襯墊芯片的示意圖和橫截面結構。
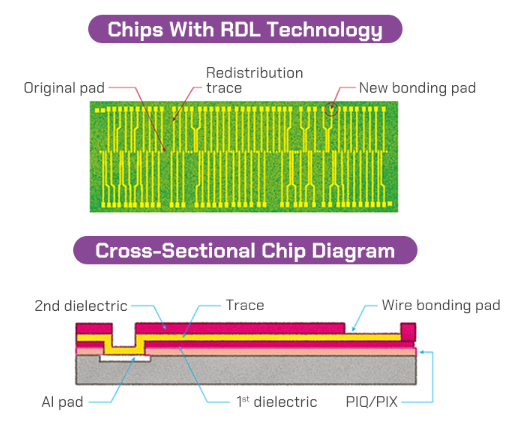
TSV(硅通孔)工藝
硅通孔是一種通過在硅片上鉆孔來容納電極的芯片堆疊技術。硅通孔封裝的主要優勢在于性能優越且封裝尺寸較小。相比采用傳統引線方法實現芯片與芯片互連或芯片與基板互連,硅通孔通過在芯片上鉆孔并填充金屬等導電材料來實現芯片垂直互連。
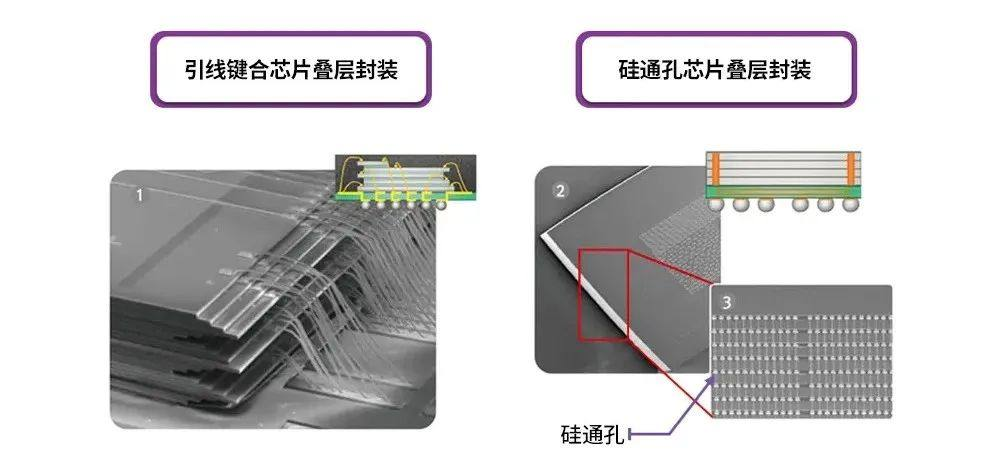
使用硅通孔技術的芯片剖面圖(? HANOL出版社)
資料來源于網絡公開資料,侵刪



