SiC外延生長技術是SiC功率器件制備的核心技術之一,外延質量直接影響SiC器件的性能。目前應用較多的SiC外延生長方法是化學氣相沉積(CVD),本文簡要介紹其生產過程及注意事項。
SiC有多種穩定的晶體多型(polytype)。因此,為了使獲得的外延生長層能夠繼承SiC襯底的特定晶體多型,需要將襯底的原子三維排列信息傳遞給外延生長層,這需要一些巧妙的設計和方法。其中一種SiC外延生長法,在SiC襯底的低指數晶面上小偏角方向上,用適當的生長條件,進行化學氣相沉積(CVD)。這種方法是由京都大學名譽教授松波弘之等人發現的,稱為臺階控制外延生長法(Step-Controlled Epitaxy)。
圖1展示了使用臺階控制外延生長法進行SiC外延生長的概念圖。通過清潔具有偏角的SiC襯底表面,形成分子層級的臺階和臺面結構。當原料氣體流動時,原料被供應到該表面,原料在臺面移動,并被分布在各處的臺階捕獲。捕獲的原料在該位置上形成與作為基底的SiC襯底晶體多型一致的排列,從而使外延層得以生長。

圖1:帶有(0001)偏角的襯底上SiC外延生長概念圖
在臺階控制外延生長中,當生長條件不合適時,原料在臺面上而不是在臺階上成核并生成晶體,因此會生長出不同的晶體多型。混入外延層中的異種多型對器件來說是致命的缺陷,因此在臺階控制外延生長中,需要設置合適的偏角,以獲得適當的臺階寬度,并優化原料氣體中Si原料和C原料的濃度、生長溫度等條件,選擇在臺階上優先形成晶體的條件。目前市場上銷售的4H型SiC襯底的表面呈現4°偏角(0001)面,是基于臺階控制外延生長的要求以及增加從boule中獲得的晶圓數量這兩個要求而決定的。
通過化學氣相沉積法進行SiC外延生長時,通常使用高純度氫氣作為載體,向保持在1500~1600℃高溫的SiC襯底表面供應SiH4等Si原料以及C3H8等C原料。在這種高溫下,如果設備內壁等周圍溫度較低,向襯底表面的原料供應效率會大幅降低,因此采用熱壁型反應器。關于SiC的外延生長設備,有多種方式,包括立式、水平式、多晶片式和單晶片式等。圖2、圖3和圖4展示了各種外延生長設備反應器部分的氣流和襯底配置示例。 圖2:多晶片自轉公轉型(從上方引入氣體) 圖3:多晶片公轉型(從側面引入氣體)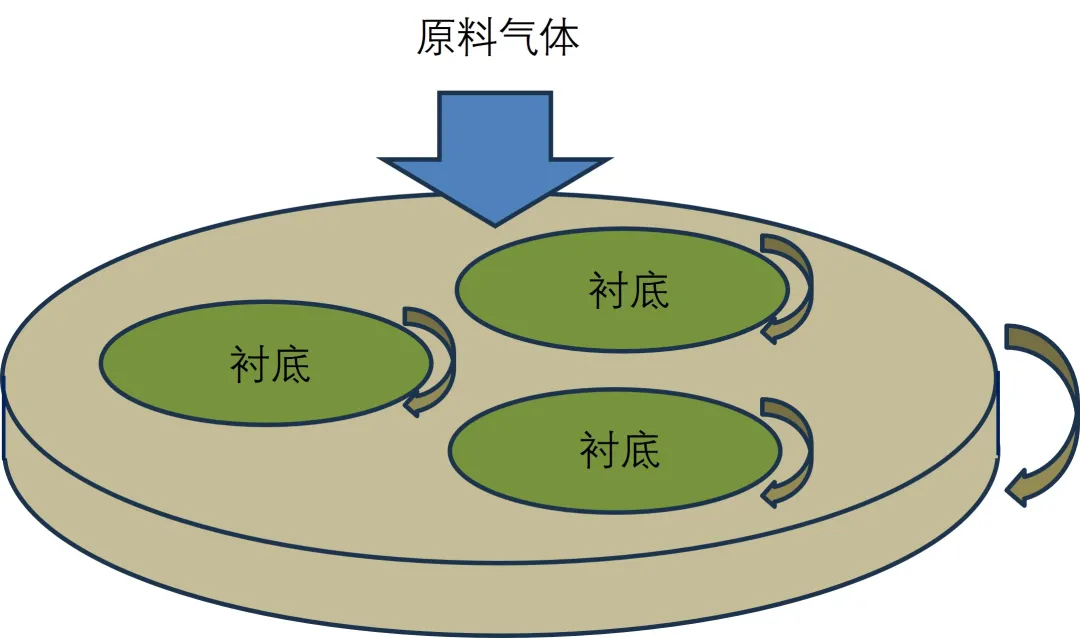

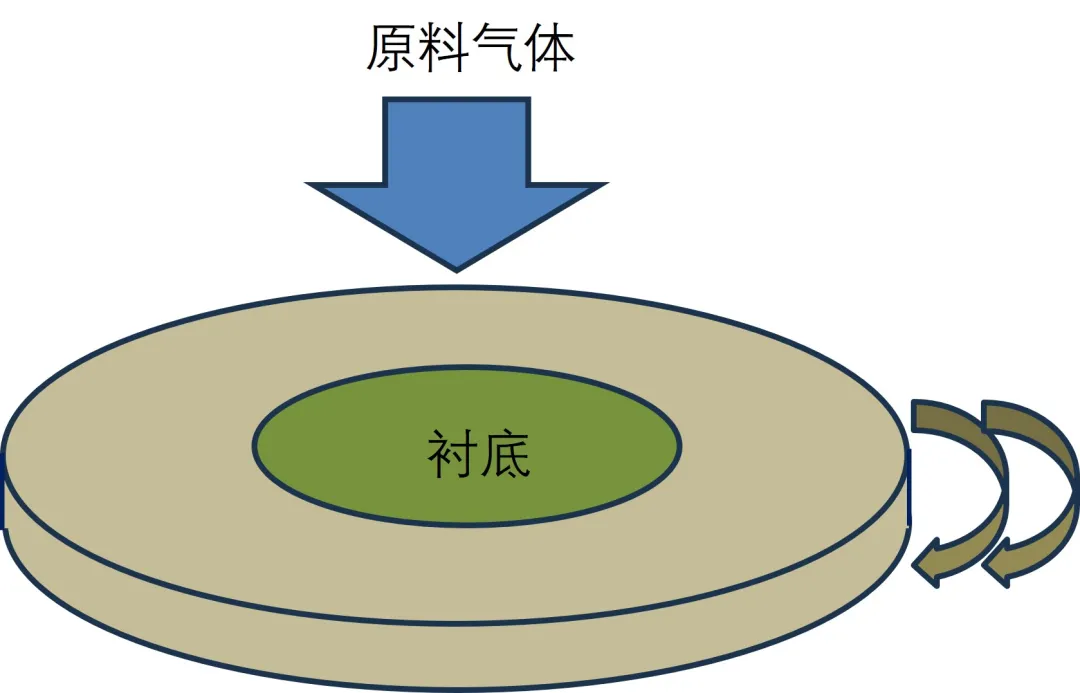
圖4:單晶片高速旋轉型
考慮到SiC外延襯底的量產,需考慮以下幾個要點:外延層厚度的均勻性、摻雜濃度的均勻性、粉塵、產量、部件更換頻率以及維護的便利性。關于摻雜濃度的均勻性,由于它直接影響器件的耐壓分布,因此要求晶圓表面、批次內以及批次間的均勻性。目前,針對8英寸襯底的SiC外延生長設備的研發正在進行中,從降低成本的角度來看,期待能夠實現更適合量產的設備。此外,附著在反應器內的部件和排氣系統上的反應生成物是粉塵源,因此正在開發氣體蝕刻技術,以方便清除這些粉塵。
通過SiC的外延生長,形成可用于制造功率器件的高純度SiC單晶層。此外,外延生長還可以將襯底內存在的基面位錯(BPD)轉換為襯底/漂移層界面處的貫穿刃位錯(TED)(參見圖5)。正如第5講中所述,當雙極電流流過時,BPD會發生堆垛層錯擴展,從而導致導通電阻增加等器件特性的劣化。然而,轉換后的TED不會對器件的電氣特性產生影響。因此,適當的外延生長可以大幅減少由于雙極電流引起的劣化。
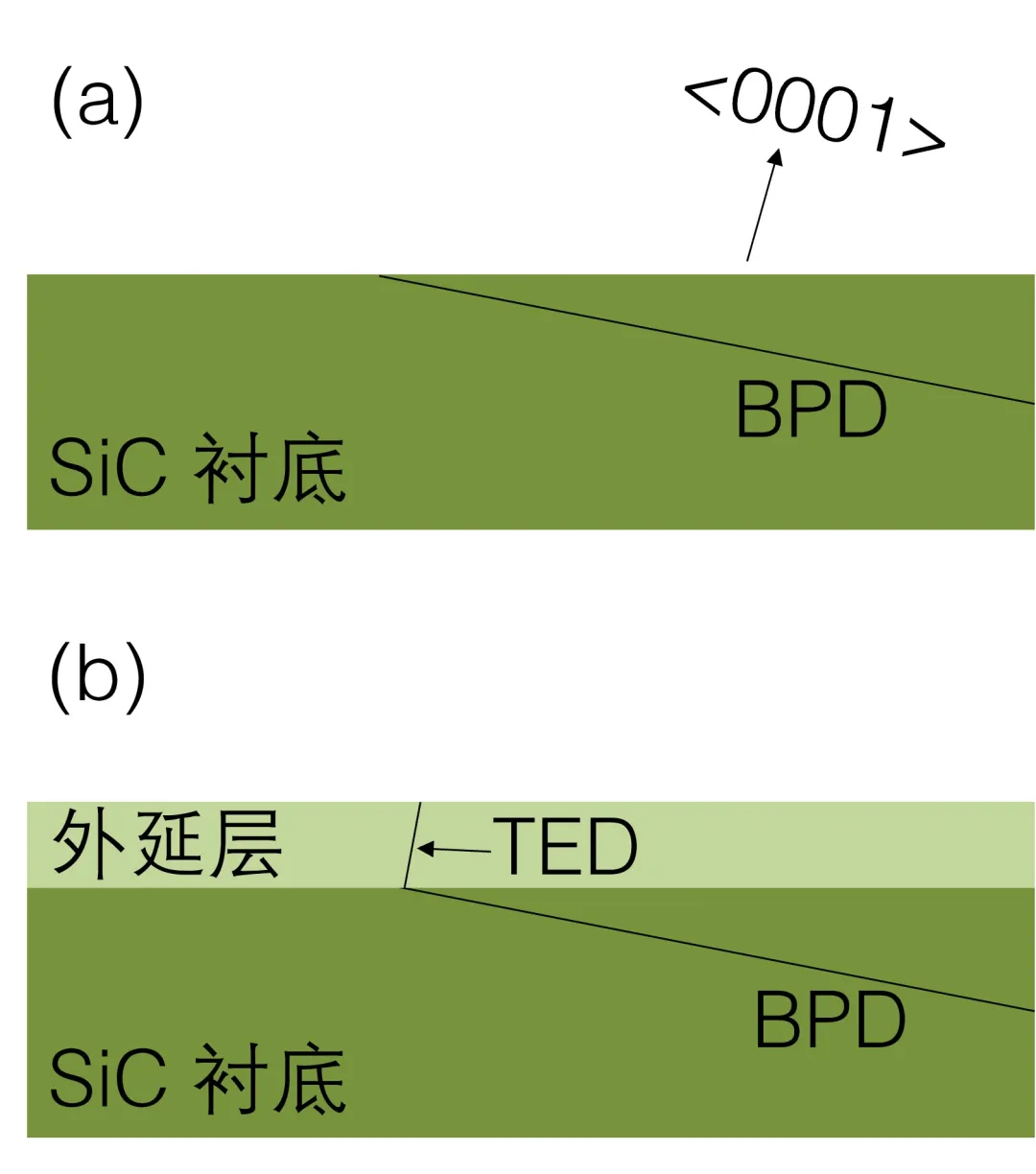
圖5:SiC襯底中的BPD和轉換后的TED橫截面示意圖
(a)外延生長前;(b)外延生長后;
通常,在SiC的外延生長中,會在漂移層和襯底之間插入緩沖層。緩沖層通常進行高濃度的n型摻雜,這有助于促進少數載流子的復合。緩沖層還承擔著上述基面位錯(BPD)轉換的作用,并且對成本的影響也很大,是器件制造中的一項重要技術。
文章來源:艾邦半導體



